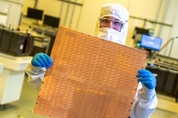
인텔은 차세대 첨단 패키징을 위한 유리 기판 기술을 19일 공개했다. 해당 유리 기판은 2030년 내 출시 예정이다. 인텔 조립 및 테스트 기술 개발 부문 총괄 바박 사비 부사장은 "10년간의 연구 끝에 인텔은 첨단 패키징에 활용할 업계 선도적인 유리 기판을 확보했다"며 "앞으로 수십 년간 주요 업체 및 파운드리 고객이 수혜를 누릴 수 있는 최첨단 기술을 선보일 것으로 기대한다"고 말했다. 오늘날의 유기 기판에 비해 유리는 매우 낮은 평탄도, 더 나은 열적(thermal) 및 기계적 안정성과 같은 뛰어난 특성을 제공해 기판의 상호 연결 밀도를 훨씬 더 높일 수 있다. 이러한 이점을 바탕으로 칩 설계자는 AI와 같은 데이터 집약적인 워크로드용 고밀도 및 고성능 칩 패키지를 만들 수 있는 것이다. 인텔에 따르면 2030년까지 반도체 산업은 유기 재료를 사용해 실리콘 패키지의 트랜지스터를 확장하는 데 한계에 도달할 가능성이 높다. 유기 재료는 더 낮은 전력효율성 및 수축과 뒤틀림과 같은 한계를 지닌다. 반도체 산업의 발전과 진화에 있어 확장성은 결정적이며, 유리 기판은 차세대 반도체를 구현하기 위해 실행 가능한 필수적인 단계다. 더욱 강력한 성능에 대한 요구가 높
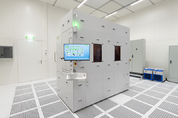
모듈 용량 늘려 생산성 높이고, 아키텍처 개선을 통해 장비 풋프린트 축소 EV Group(이하 EVG)은 자사의 리소그래피 솔루션 포트폴리오에 속하는 차세대 200mm 제품으로서 EVG150 자동화 레지스트 처리 시스템을 출시한다고 8일 밝혔다. 새로운 디자인의 EVG150 플랫폼은 이전 세대 플랫폼과 비교해 최대 80퍼센트까지 더 높은 생산성, 우수한 범용성, 50퍼센트 더 작은 풋프린트가 특징이다. 범용 플랫폼으로서 신뢰할 수 있는 고품질 코팅 및 현상 공정을 가능하게 하므로, 첨단 패키징, MEMS, RF, 3D 센싱, 전력 반도체, 포토닉스를 비롯한 다양한 디바이스 및 애플리케이션에 적용할 수 있다. 오는 15일부터 18일까지 나흘간 독일 뮌헨의 메세 뮌헨에서 개최되는 세미콘 유로파(SEMICON Europa) 전시회에서 EVG 부스를 방문하면 EVG의 임직원들로부터 직접 차세대 EVG150 레지스트 처리 시스템에 관한 설명을 들을 수 있다. 세계적인 EBS(electronic based system) 연구 센터인 실리콘 오스트리아 랩스는 차세대 EVG150 시스템의 첫 번째 고객이다. 실리콘 오스트리아 랩스의 마이크로시스템 연구 부문장인 모센 모리디